전자 기기의 소형화, 다기능화, 고전력 소비 및 향상된 신뢰성으로의 급속한 발전과 함께, 마이크로전자 기기를 위한 고밀도 3차원 집적 기술이 등장했습니다. 그러나 고밀도 집적 기술의 발전은 칩 내부의 열 집중으로 인한 접합부 온도 상승에 의해 제약을 받으며, 이는 기기 성능과 신뢰성을 크게 저해합니다.
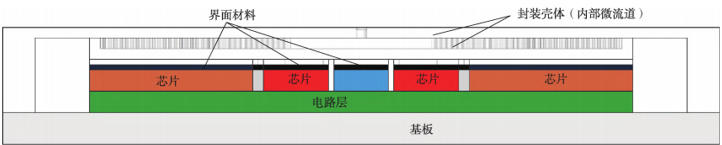
통합 칩은 기판층, 회로층 칩, 칩, 패키지 쉘 냉판으로 구성된 다층 구조를 특징으로 한다. 패키지 쉘 냉판에는 회로층 칩의 열을 액체 대류 열전달을 통해 방출하는 동시에 균일한 칩 온도 분포를 보장하는 미세 채널이 통합되어 있다. 유연한 열전도성 재료(TIM)는 패키지 쉘 냉판과 회로층 사이의 인터페이스를 연결한다.
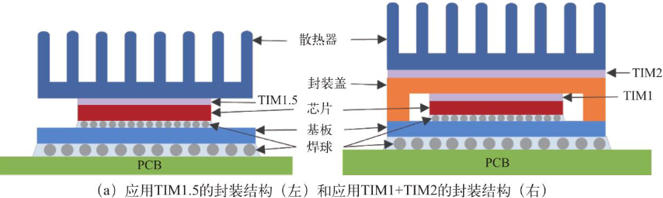
열전도성 접촉재(TIM)는 표면 사이의 미세 틈새를 채워 열 성능을 직접 향상시키는 핵심 방열 부품입니다. TIM은 일반적으로 칩과 패키지 뚜껑 사이(TIM1), 칩과 방열판 사이(TIM1.5), 패키지 뚜껑과 방열판 사이(TIM2)에 적용됩니다. TIM의 높은 열전도성과 신뢰성은 인터페이스 간 신속한 열 전달을 보장합니다. 고성능 컴퓨팅 칩에 대한 주류 열 관리 방식은 여전히 초저열저항 TIM1 재료를 활용하여 칩 내부에서 패키지 하우징으로 열을 신속히 전달합니다. 이후 열은 TIM2 재료를 통해 액체 냉각판으로 이동하며, 내부 냉각 유체의 빠른 흐름을 통해 외부 환경으로 신속히 방출됩니다.

또한 저온 접합 기술은 패키징 공정에서 널리 채택되고 있습니다. 예를 들어, 저온 Cu-Cu 접합은 고밀도 상호 연결 및 우수한 전기적·열적 전도성이라는 장점으로 인해 첨단 패키징의 핵심 기술이 되었습니다. 나노 실버 소결 공정은 저온 접합 기술의 대표적인 사례입니다. 이 공정은 낮은 온도(250°C)에서 높은 열전도율(250 W/(m·K))을 가진 접합 인터페이스를 형성하여, 기존 고온 공정에서 발생하는 열적 손상을 효과적으로 방지합니다. 결과적으로 생성된 접합 구조는 극히 낮은 기공률, 탁월한 열전도성, 그리고 뛰어난 기계적 안정성을 보여줌으로써 첨단 패키징에 대한 신뢰성을 보장합니다.